A SMT usa análise e solução de cavidade de soldagem por refluxo de ar de pasta de solda convencional (Edição Essence 2023), você merece!
1 Introdução

Na montagem da placa de circuito, a pasta de solda é primeiramente impressa na almofada de solda da placa de circuito e, em seguida, os diversos componentes eletrônicos são fixados. Finalmente, após o forno de refluxo, as esferas de estanho na pasta de solda são derretidas e todos os tipos de componentes eletrônicos e a almofada de solda da placa de circuito são soldados para realizar a montagem de submódulos elétricos. A tecnologia de montagem em superfície (SMT) é cada vez mais utilizada em produtos de encapsulamento de alta densidade, como encapsulamentos de nível de sistema (SIP), dispositivos Ball Gridarray (BGA) e Power Bare Chip, encapsulamentos sem pinos planos quadrados (quad AATNo-lead, conhecidos como QFN).
Devido às características do processo de soldagem de pasta de solda e dos materiais, após a soldagem por refluxo desses dispositivos de grande superfície de solda, haverá furos na área de soldagem de solda, o que afetará as propriedades elétricas, térmicas e mecânicas do desempenho do produto e até mesmo levará à falha do produto. Portanto, para melhorar a cavidade de soldagem por refluxo de pasta de solda, tornou-se um processo e um problema técnico que deve ser resolvido. Alguns pesquisadores analisaram e estudaram as causas da cavidade de soldagem de bola de solda BGA e forneceram soluções de melhoria. A área de soldagem por refluxo de pasta de solda convencional com QFN maior que 10 mm2 ou área de soldagem maior que 6 mm2 não possui solução de cavaco descoberto.
Utilize soldagem por pré-moldagem e soldagem por forno de refluxo a vácuo para melhorar o furo de solda. A solda pré-fabricada requer equipamento especial para o fluxo pontual. Por exemplo, o chip é deslocado e inclinado significativamente após ser colocado diretamente na solda pré-fabricada. Se o chip de montagem de fluxo for refluído e, em seguida, refluído, o processo é aumentado em dois refluxos, e o custo da solda pré-fabricada e do material de fluxo é muito maior do que o da pasta de solda.
O equipamento de refluxo a vácuo é mais caro, a capacidade de vácuo da câmara de vácuo independente é muito baixa, o custo-benefício não é alto e o problema de respingos de estanho é grave, o que é um fator importante na aplicação de produtos de alta densidade e passo fino. Neste artigo, com base no processo convencional de soldagem por refluxo de pasta de solda, um novo processo de soldagem por refluxo secundário é desenvolvido e apresentado para melhorar a cavidade de soldagem e solucionar os problemas de colagem e rachaduras na vedação plástica causados pela cavidade de soldagem.
2 Cavidade de soldagem por refluxo de impressão de pasta de solda e mecanismo de produção
2.1 Cavidade de soldagem
Após a soldagem por refluxo, o produto foi testado por raio X. Os furos na zona de soldagem com coloração mais clara foram devidos à solda insuficiente na camada de solda, conforme mostrado na Figura 1.
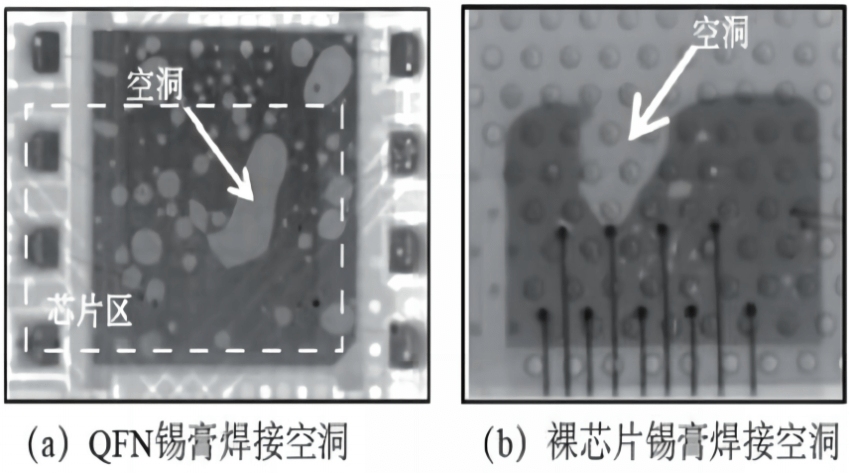
Detecção de raios X do buraco da bolha
2.2 Mecanismo de formação da cavidade de soldagem
Tomando a pasta de solda sAC305 como exemplo, a composição e a função principais são mostradas na Tabela 1. O fluxo e as esferas de estanho são unidos em forma de pasta. A relação em peso entre solda de estanho e fluxo é de cerca de 9:1, e a relação em volume é de cerca de 1:1.

Após a impressão e a montagem da pasta de solda com diversos componentes eletrônicos, ela passa por quatro estágios: pré-aquecimento, ativação, refluxo e resfriamento ao passar pelo forno de refluxo. O estado da pasta de solda também varia de acordo com as temperaturas em cada estágio, como mostrado na Figura 2.
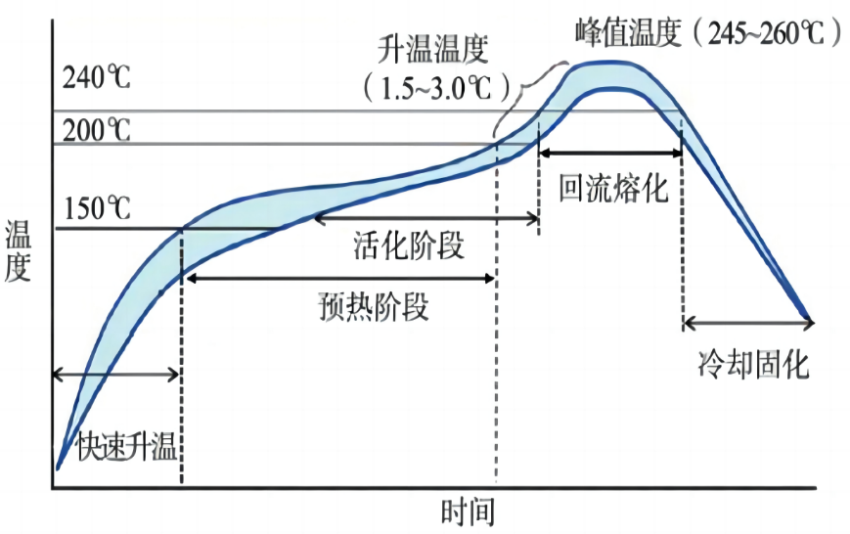
Referência de perfil para cada área de soldagem por refluxo
No estágio de pré-aquecimento e ativação, os componentes voláteis no fluxo na pasta de solda serão volatilizados em gás quando aquecidos. Ao mesmo tempo, gases serão produzidos quando o óxido na superfície da camada de solda for removido. Alguns desses gases irão volatilizar e deixar a pasta de solda, e os cordões de solda serão fortemente condensados devido à volatilização do fluxo. No estágio de refluxo, o fluxo restante na pasta de solda evaporará rapidamente, os cordões de estanho derreterão, uma pequena quantidade de gás volátil do fluxo e a maior parte do ar entre os cordões de estanho não serão dispersos a tempo, e o residual no estanho fundido e sob a tensão do estanho fundido são estrutura de sanduíche de hambúrguer e são capturados pela almofada de solda da placa de circuito e componentes eletrônicos, e o gás envolto no estanho líquido é difícil de escapar apenas pela flutuabilidade ascendente. O tempo de fusão superior é muito curto. Quando o estanho derretido esfria e se torna estanho sólido, poros aparecem na camada de soldagem e furos de solda são formados, como mostrado na Figura 3.
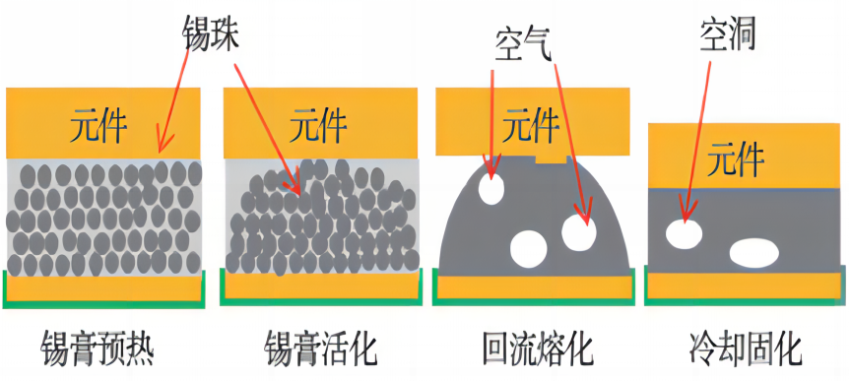
Diagrama esquemático do vazio gerado pela soldagem por refluxo de pasta de solda
A causa raiz da cavidade de soldagem é que o ar ou gás volátil envolvido na pasta de solda após a fusão não é completamente descarregado. Os fatores que influenciam incluem o material da pasta de solda, o formato da impressão da pasta de solda, a quantidade de impressão da pasta de solda, a temperatura de refluxo, o tempo de refluxo, o tamanho da solda, a estrutura, etc.
3. Verificação dos fatores de influência na impressão de pasta de solda em furos de soldagem por refluxo
Testes de QFN e de cavacos descobertos foram usados para confirmar as principais causas de vazios de soldagem por refluxo e para encontrar maneiras de melhorar os vazios de soldagem por refluxo impressos pela pasta de solda. O perfil do produto de soldagem por refluxo de pasta de solda QFN e cavacos descobertos é mostrado na Figura 4, o tamanho da superfície de soldagem QFN é 4,4 mm x 4,1 mm, a superfície de soldagem é uma camada estanhada (estanho 100% puro); O tamanho da soldagem do cavaco descoberto é 3,0 mm x 2,3 mm, a camada de soldagem é uma camada bimetálica de níquel-vanádio pulverizada e a camada superficial é de vanádio. A almofada de soldagem do substrato foi de níquel-paládio químico por imersão em ouro, e a espessura foi de 0,4 μm / 0,06 μm / 0,04 μm. A pasta de solda SAC305 é usada, o equipamento de impressão de pasta de solda é DEK Horizon APix, o equipamento do forno de refluxo é BTUPyramax150N e o equipamento de raio-X é DAGExD7500VR.
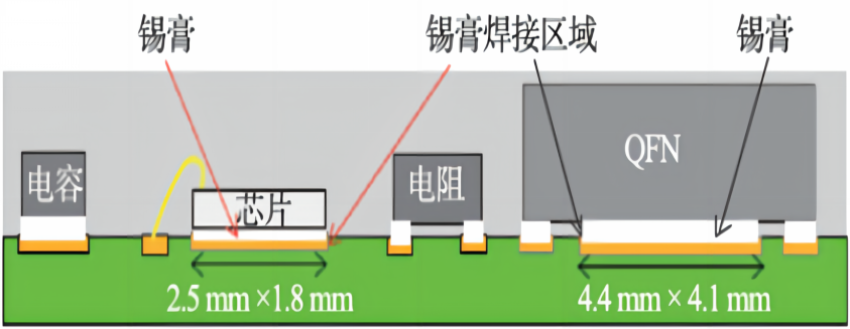
Desenhos de soldagem QFN e cavacos nus
Para facilitar a comparação dos resultados dos testes, a soldagem por refluxo foi realizada nas condições da Tabela 2.

Tabela de condições de soldagem por refluxo
Após a montagem da superfície e a soldagem por refluxo serem concluídas, a camada de soldagem foi detectada por raio X, e foi descoberto que havia grandes furos na camada de soldagem na parte inferior do QFN e no chip descoberto, conforme mostrado na Figura 5.
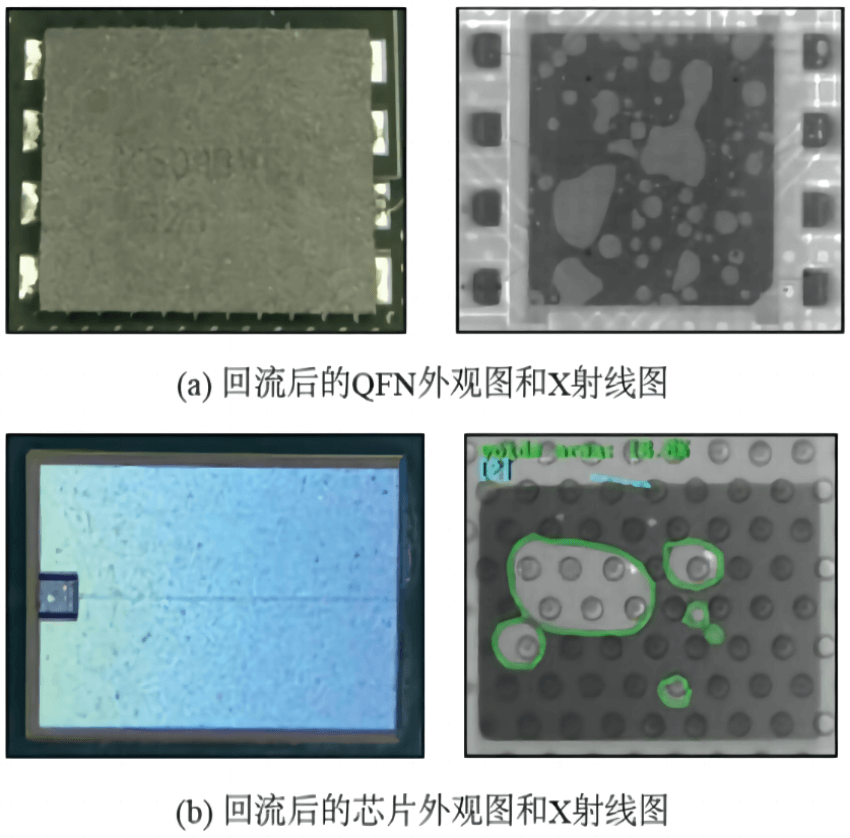
QFN e holograma de chip (raio-X)
Como o tamanho do cordão de estanho, a espessura da malha de aço, a taxa de área de abertura, o formato da malha de aço, o tempo de refluxo e a temperatura máxima do forno afetam os vazios de soldagem por refluxo, há muitos fatores de influência que serão verificados diretamente pelo teste de DOE, e o número de grupos experimentais será muito grande. É necessário rastrear e determinar rapidamente os principais fatores de influência por meio de testes de comparação de correlação e, em seguida, otimizar ainda mais os principais fatores de influência por meio do DOE.
3.1 Dimensões dos furos de solda e das esferas de pasta de solda
No teste com pasta de solda SAC305 tipo 3 (tamanho do cordão de 25-45 μm), as demais condições permanecem inalteradas. Após o refluxo, os furos na camada de solda são medidos e comparados com a pasta de solda tipo 4. Constatou-se que os furos na camada de solda não apresentam diferenças significativas entre os dois tipos de pasta de solda, indicando que a pasta de solda com diferentes tamanhos de cordão não tem influência óbvia nos furos na camada de solda, o que não é um fator de influência, como mostrado na Figura 6.

Comparação de furos de pó de estanho metálico com diferentes tamanhos de partículas
3.2 Espessura da cavidade de soldagem e da malha de aço impressa
Após o refluxo, a área da cavidade da camada soldada foi medida com a malha de aço impressa com espessuras de 50 μm, 100 μm e 125 μm, mantendo-se as demais condições inalteradas. Verificou-se que o efeito de diferentes espessuras da malha de aço (pasta de solda) na QFN foi comparado com o da malha de aço impressa com espessura de 75 μm. À medida que a espessura da malha de aço aumenta, a área da cavidade diminui gradualmente. Após atingir uma determinada espessura (100 μm), a área da cavidade se inverte e começa a aumentar com o aumento da espessura da malha de aço, conforme mostrado na Figura 7.
Isso mostra que, quando a quantidade de pasta de solda é aumentada, o estanho líquido com refluxo é coberto pelo chip, e a saída de ar residual é estreita apenas nos quatro lados. Quando a quantidade de pasta de solda é alterada, a saída de ar residual também é aumentada, e a explosão instantânea de ar envolto em estanho líquido ou gás volátil escapando de estanho líquido fará com que o estanho líquido espirre ao redor do QFN e do chip.
O teste descobriu que, com o aumento da espessura da malha de aço, o estouro de bolhas causado pelo escape de ar ou gás volátil também aumentará, e a probabilidade de respingos de estanho ao redor do QFN e do chip também aumentará correspondentemente.

Comparação de furos em malha de aço de diferentes espessuras
3.3 Relação entre a área da cavidade de soldagem e a abertura da malha de aço
A malha de aço impressa com taxas de abertura de 100%, 90% e 80% foi testada, e as demais condições permaneceram inalteradas. Após o refluxo, a área da cavidade da camada soldada foi medida e comparada com a malha de aço impressa com taxa de abertura de 100%. Constatou-se que não houve diferença significativa na cavidade da camada soldada nas condições de taxa de abertura de 100% e 90% e 80%, conforme mostrado na Figura 8.

Comparação de cavidades de diferentes áreas de abertura de diferentes malhas de aço
3.4 Cavidade soldada e forma de malha de aço impressa
No teste de forma de impressão da pasta de solda da tira b e da grade inclinada c, as demais condições permaneceram inalteradas. Após o refluxo, a área da cavidade da camada de solda é medida e comparada com a forma de impressão da grade a. Constatou-se que não há diferença significativa na cavidade da camada de solda nas condições de grade, tira e grade inclinada, conforme mostrado na Figura 9.
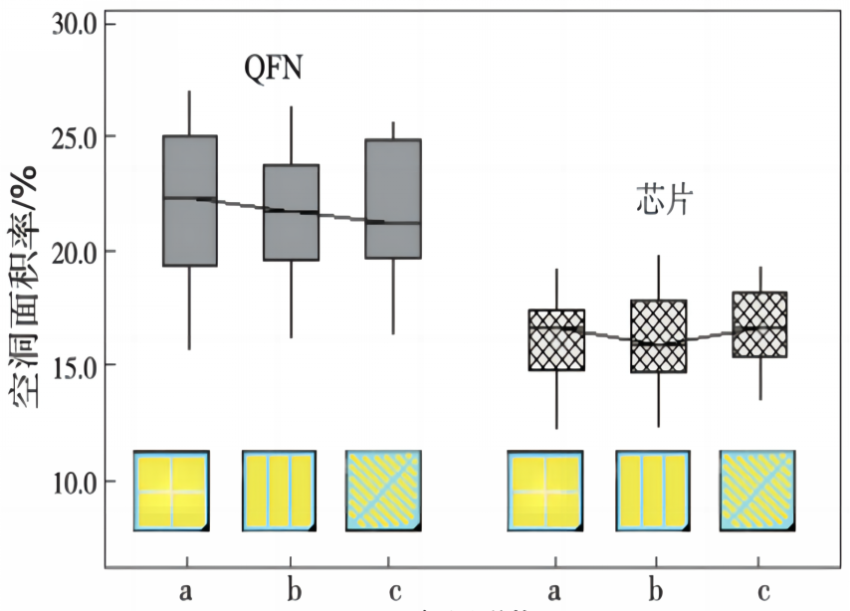
Comparação de furos em diferentes modos de abertura de malha de aço
3.5 Cavidade de soldagem e tempo de refluxo
Após um teste de tempo de refluxo prolongado (70 s, 80 s, 90 s), as demais condições permaneceram inalteradas. O furo na camada de solda foi medido após o refluxo e, em comparação com o tempo de refluxo de 60 s, constatou-se que, com o aumento do tempo de refluxo, a área do furo de solda diminuiu, mas a amplitude de redução diminuiu gradualmente com o aumento do tempo, conforme mostrado na Figura 10. Isso demonstra que, em caso de tempo de refluxo insuficiente, o aumento do tempo de refluxo conduz ao transbordamento total do ar envolto em estanho líquido fundido. No entanto, após o aumento do tempo de refluxo para um determinado tempo, o ar envolto em estanho líquido torna-se difícil de transbordar novamente. O tempo de refluxo é um dos fatores que afetam a cavidade de solda.

Comparação de vazios de diferentes durações de tempo de refluxo
3.6 Cavidade de soldagem e temperatura máxima do forno
Com o teste de temperatura de pico do forno de 240 ℃ e 250 ℃ e outras condições inalteradas, a área da cavidade da camada soldada foi medida após o refluxo e comparada com a temperatura de pico do forno de 260 ℃, foi descoberto que sob diferentes condições de temperatura de pico do forno, a cavidade da camada soldada de QFN e cavaco não mudou significativamente, conforme mostrado na Figura 11. Isso mostra que diferentes temperaturas de pico do forno não têm efeito óbvio no QFN e no furo na camada de soldagem do cavaco, o que não é um fator de influência.

Comparação de vazios de diferentes temperaturas de pico
Os testes acima indicam que os fatores significativos que afetam a cavidade da camada de solda do QFN e do cavaco são o tempo de refluxo e a espessura da malha de aço.
4 Melhoria da cavidade de soldagem por refluxo de impressão de pasta de solda
4.1 Teste DOE para melhorar a cavidade de soldagem
O furo na camada de soldagem de QFN e cavaco foi melhorado encontrando o valor ótimo dos principais fatores de influência (tempo de refluxo e espessura da malha de aço). A pasta de solda era SAC305 tipo 4, o formato da malha de aço era do tipo grade (grau de abertura de 100%), a temperatura máxima do forno era de 260 ℃ e outras condições de teste eram as mesmas que as do equipamento de teste. O teste DOE e os resultados são mostrados na Tabela 3. As influências da espessura da malha de aço e do tempo de refluxo nos furos de soldagem de QFN e cavaco são mostradas na Figura 12. Através da análise de interação dos principais fatores de influência, descobriu-se que o uso de espessura de malha de aço de 100 μm e tempo de refluxo de 80 s pode reduzir significativamente a cavidade de soldagem de QFN e cavaco. A taxa de cavidade de soldagem de QFN é reduzida do máximo de 27,8% para 16,1%, e a taxa de cavidade de soldagem de cavaco é reduzida do máximo de 20,5% para 14,5%.
No teste, 1.000 produtos foram produzidos sob as condições ideais (espessura da malha de aço de 100 μm, tempo de refluxo de 80 s), e a taxa de cavidade de soldagem de 100 QFN e cavacos foi medida aleatoriamente. A taxa média de cavidade de soldagem do QFN foi de 16,4%, e a taxa média de cavidade de soldagem do cavaco foi de 14,7%. A taxa de cavidade de soldagem do cavaco e do cavaco foi significativamente reduzida.

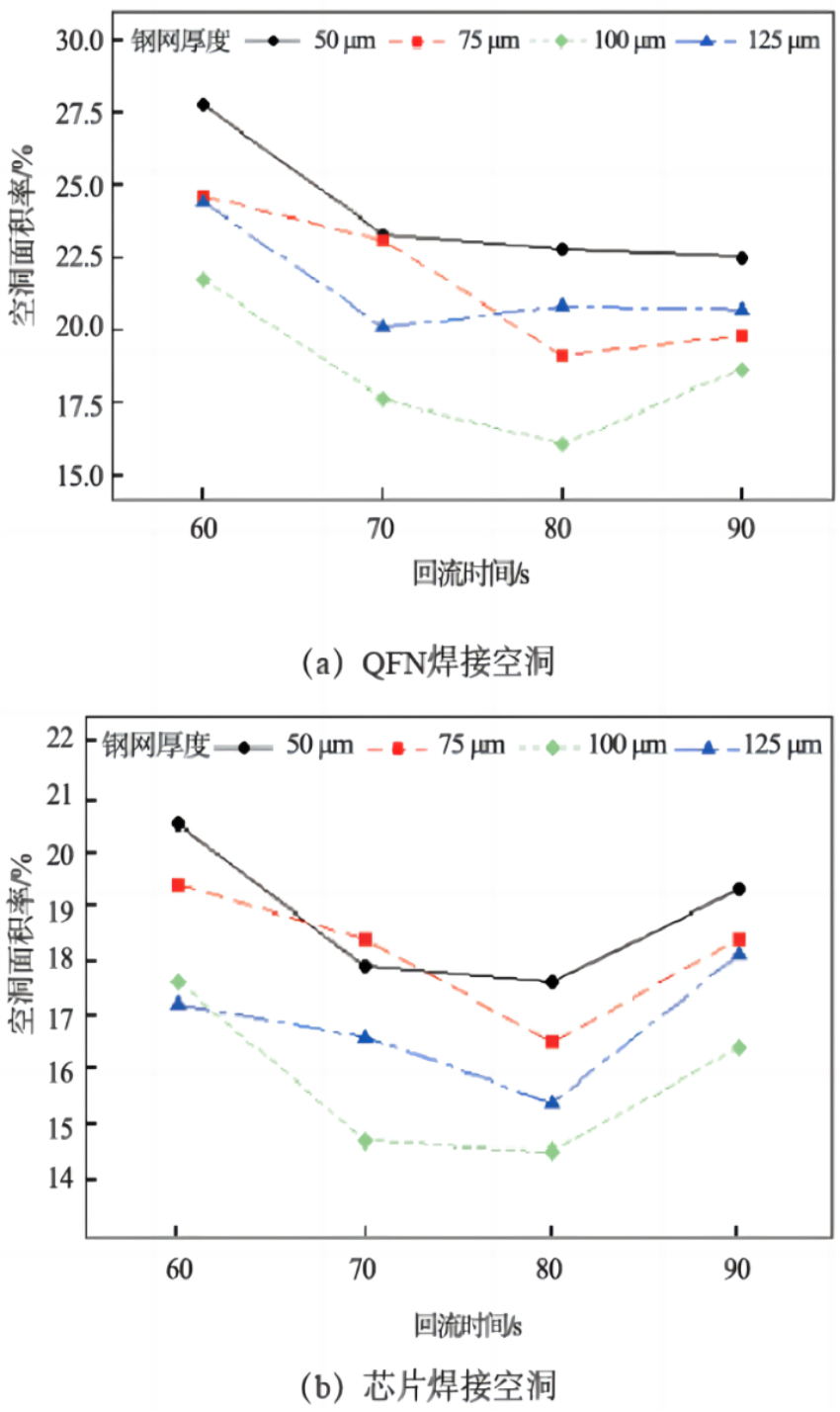
4.2 O novo processo melhora a cavidade de soldagem
A situação real de produção e os testes demonstram que, quando a área da cavidade de soldagem na base do chip é inferior a 10%, o problema de trincas na posição da cavidade do chip não ocorre durante a colagem e moldagem do chumbo. Os parâmetros de processo otimizados pelo DOE não atendem aos requisitos de análise e resolução de furos na soldagem por refluxo de pasta de solda convencional, e a taxa de área da cavidade de soldagem do chip precisa ser ainda mais reduzida.
Como o chip revestido pela solda impede que o gás presente na solda escape, a taxa de furos na parte inferior do chip é ainda mais reduzida pela eliminação ou redução do gás revestido pela solda. Adota-se um novo processo de soldagem por refluxo com duas impressões de pasta de solda: uma impressão de pasta de solda, uma por refluxo sem cobertura do QFN e um chip descoberto descarregando o gás da solda. O processo específico de impressão secundária de pasta de solda, patch e refluxo secundário é mostrado na Figura 13.
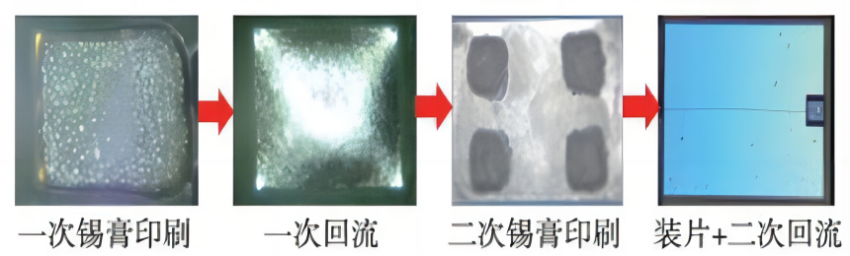
Quando a pasta de solda de 75 μm de espessura é impressa pela primeira vez, a maior parte do gás na solda sem a cobertura do chip escapa da superfície, e a espessura após o refluxo é de cerca de 50 μm. Após a conclusão do refluxo primário, pequenos quadrados são impressos na superfície da solda solidificada resfriada (a fim de reduzir a quantidade de pasta de solda, reduzir a quantidade de derramamento de gás, reduzir ou eliminar respingos de solda), e a pasta de solda com uma espessura de 50 μm (os resultados do teste acima mostram que 100 μm é o melhor, então a espessura da impressão secundária é de 100 μm.50 μm = 50 μm), em seguida, instale o chip e retorne após 80 s. Quase não há furo na solda após a primeira impressão e refluxo, e a pasta de solda na segunda impressão é pequena, e o furo de soldagem é pequeno, como mostrado na Figura 14.
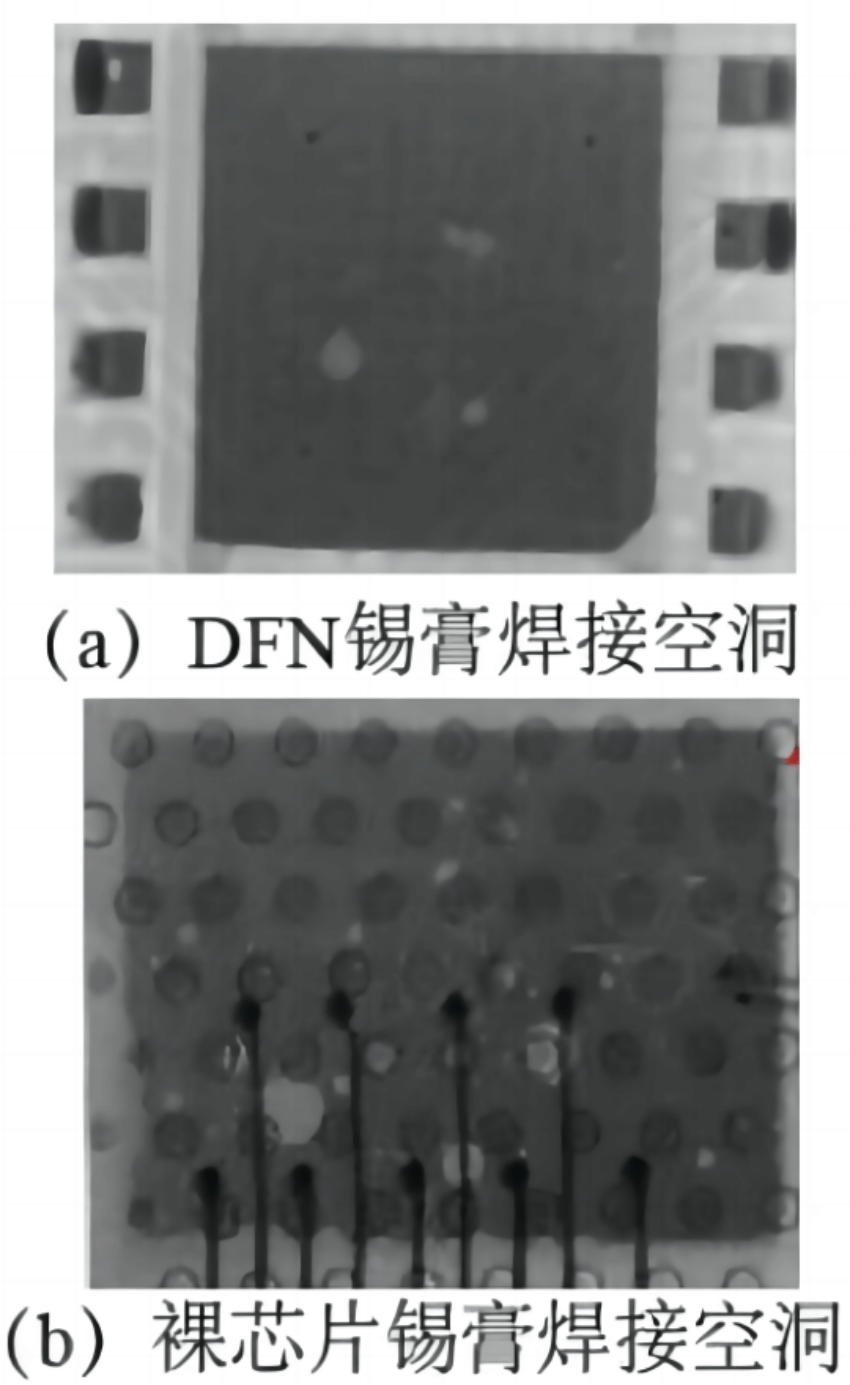
Após duas impressões de pasta de solda, desenho oco
4.3 Verificação do efeito da cavidade de soldagem
Produção de 2000 produtos (a espessura da primeira malha de aço de impressão é de 75 μm, a espessura da segunda malha de aço de impressão é de 50 μm), outras condições inalteradas, medição aleatória de 500 QFN e taxa de cavidade de soldagem de cavacos, descobriu-se que o novo processo após o primeiro refluxo não apresenta cavidade, após o segundo QFN de refluxo a taxa máxima de cavidade de soldagem é de 4,8%, e a taxa máxima de cavidade de soldagem do cavaco é de 4,1%. Comparado com o processo original de soldagem de impressão de pasta única e o processo otimizado DOE, a cavidade de soldagem é significativamente reduzida, conforme mostrado na Figura 15. Não foram encontradas rachaduras de cavacos após os testes funcionais de todos os produtos.

5 Resumo
A otimização da quantidade de pasta de solda impressa e do tempo de refluxo pode reduzir a área da cavidade de soldagem, mas a taxa de cavidade de soldagem ainda é alta. O uso de duas técnicas de soldagem por refluxo com pasta de solda impressa pode efetivamente maximizar a taxa de cavidade de soldagem. A área de soldagem do chip nu do circuito QFN pode ser de 4,4 mm x 4,1 mm e 3,0 mm x 2,3 mm, respectivamente, na produção em massa. A taxa de cavidade da soldagem por refluxo é controlada abaixo de 5%, o que melhora a qualidade e a confiabilidade da soldagem por refluxo. A pesquisa neste artigo fornece uma referência importante para a melhoria do problema da cavidade de soldagem em superfícies de soldagem de grandes áreas.






